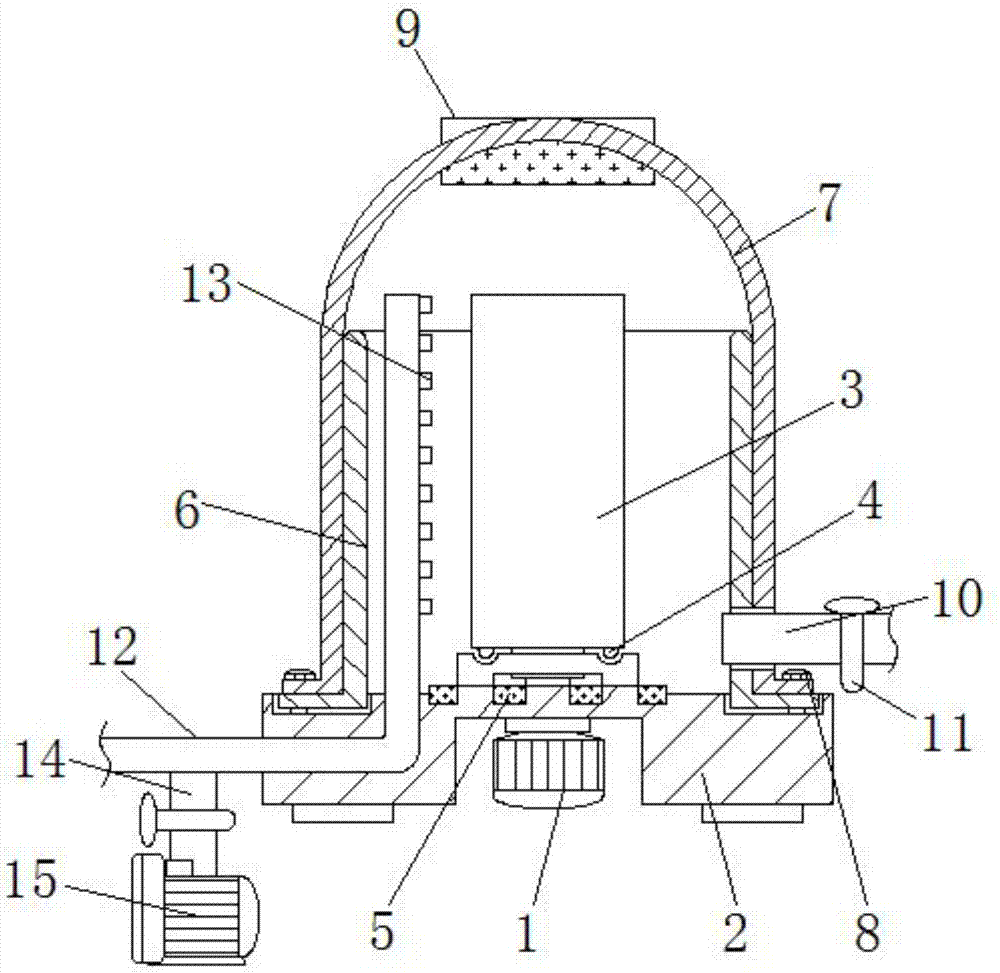
技术领域
本发明涉及半导体生产技术领域,具体为一种半导体生产用等离子辅助化学气相沉积装置。
背景技术
半导体,指常温下导电性能介于导体与绝缘体之间的材料;半导体在收音机、电视机以及测温上有着广泛的应用;如二极管就是采用半导体制作的器件;半导体是指一种导电性可受控制,范围可从绝缘体至导体之间的材料。
然而现有的半导体气相沉积镀膜操作工作效率底,在镀膜时晶体上容易夹杂微粒杂质,影响气相沉积镀膜的工作效率。针对上述问题,急需在原有的化学气相沉积装置基础上进行创新设计。
发明内容
本发明的目的在于提供一种半导体生产用等离子辅助化学气相沉积装置,以解决上述背景技术提出现有的半导体气相沉积镀膜操作工作效率底,在镀膜时晶体上容易夹杂微粒杂质,影响气相沉积镀膜工作效率的问题。
为实现上述目的,本发明提供如下技术方案:一种半导体生产用等离子辅助化学气相沉积装置,包括转动电机、内壁罩、上极片和出气管,所述转动电机固定安装于底盘的底部中心处,且转动电机的上端固定连接有晶体托架,并且晶体托架位于底盘的上方,所述晶体托架的底部边缘处设置有滚珠,并且晶体托架和底盘连接处的边侧安装有下极片,所述内壁罩的下端设置于底盘的顶部边缘处,且内壁罩的外侧设置有外壁罩,并且内壁罩和外壁罩均通过同一固定件固定于底盘上,所述上极片位于内壁罩上,且上极片设置于晶体托架的正上方,所述出气管安装于内壁罩和外壁罩上,且出气管上安装有气阀,并且气阀位于晶体托架的一侧,所述晶体托架的另一侧设置有输气管,且输气管的近端连接有输气喷头,并且输气管的远端安装有通气管,所述通气管上设置有另一气阀,且通气管的管端连接有气泵。
优选的,所述下极片设置为环状结构,且下极片设置有2块。
优选的,所述内壁罩和外壁罩相互贴合,且内壁罩和外壁罩均与底盘构成螺栓连接的拆卸安装结构。
优选的,所述内壁罩和外壁罩的材质为钢化玻璃,且外壁罩的顶部设置为圆弧形。
优选的,所述出气管贯穿于内壁罩和外壁罩,且出气管与内壁罩和外壁罩螺纹连接。
优选的,所述输气喷头等间距均匀设置,且输气喷头的分布长度与晶体托架的高度相等,并且晶体托架设计为旋转结构。
与现有技术相比,本发明的有益效果是:该半导体生产用等离子辅助化学气相沉积装置,设置有拆卸结构的内壁罩和外壁罩,将晶体托架设置于一个密封的环境中,通过输气管和输气喷头对半导体晶体进行镀膜,方便半导体晶体的拆卸和安装,在晶体托架上下两个方向分别设置有上极片和下极片,将晶体托架所在区域形成一个大电容环境,从而加快半导体晶体的化学气相沉积效率,拆卸式的出气管对输气管导入的气态物质进行回收再利用,额外设置的气泵,在化学气相沉积操作前运行,排出晶体托架所在区域的微粒,从而解决了晶体镀膜时会混入微粒杂质的问题。
附图说明
图1为本发明正面结构示意图;
图2为本发明出气管安装结构示意图;
图3为本发明下极片安装结构示意图。
图中:1、转动电机;2、底盘;3、晶体托架;4、滚珠;5、下极片;6、内壁罩;7、外壁罩;8、固定件;9、上极片;10、出气管;11、气阀;12、输气管;13、输气喷头;14、通气管;15、气泵。
具体实施方式
下面将结合本发明实施例中的附图,对本发明实施例中的技术方案进行清楚、完整地描述,显然,所描述的实施例仅仅是本发明一部分实施例,而不是全部的实施例。基于本发明中的实施例,本领域普通技术人员在没有做出创造性劳动前提下所获得的所有其他实施例,都属于本发明保护的范围。
请参阅图1-3,本发明提供一种技术方案:一种半导体生产用等离子辅助化学气相沉积装置,包括转动电机1、底盘2、晶体托架3、滚珠4、下极片5、内壁罩6、外壁罩7、固定件8、上极片9、出气管10、气阀11、输气管12、输气喷头13、通气管14和气泵15,转动电机1固定安装于底盘2的底部中心处,且转动电机1的上端固定连接有晶体托架3,并且晶体托架3位于底盘2的上方,晶体托架3的底部边缘处设置有滚珠4,并且晶体托架3和底盘2连接处的边侧安装有下极片5,内壁罩6的下端设置于底盘2的顶部边缘处,且内壁罩6的外侧设置有外壁罩7,并且内壁罩6和外壁罩7均通过同一固定件8固定于底盘2上,上极片9位于内壁罩6上,且上极片9设置于晶体托架3的正上方,出气管10安装于内壁罩6和外壁罩7上,且出气管10上安装有气阀11,并且气阀11位于晶体托架3的一侧,晶体托架3的另一侧设置有输气管12,且输气管12的近端连接有输气喷头13,并且输气管12的远端安装有通气管14,通气管14上设置有另一气阀11,且通气管14的管端连接有气泵15。
下极片5设置为环状结构,且下极片5设置有2块,提升上极片9和下极片5之间产生的电容强度大小,从而提高化学气相沉积工作效率。
内壁罩6和外壁罩7相互贴合,且内壁罩6和外壁罩7均与底盘2构成螺栓连接的拆卸安装结构,使得晶体托架3所在区域环境完全密封,且方便晶体托架3上半导体晶体的更换。
内壁罩6和外壁罩7的材质为钢化玻璃,且外壁罩7的顶部设置为圆弧形,防止晶体托架3上半导体晶体在转动镀膜时与外壁罩7的顶部撞击,造成半导体晶体损伤。
出气管10贯穿于内壁罩6和外壁罩7,且出气管10与内壁罩6和外壁罩7螺纹连接,方便出气管10的拆卸和安装,且对气相的镀膜物质进行回收。
输气喷头13等间距均匀设置,且输气喷头13的分布长度与晶体托架3的高度相等,并且晶体托架3设计为旋转结构,提高晶体托架3上的半导体晶体与气相镀膜物质的接触面,从而使得半导体晶体的镀膜效率提高。
工作原理:在使用该半导体生产用等离子辅助化学气相沉积装置时,首先将需要镀膜的半导体晶体等间距固定于晶体托架3上,将内壁罩6和外壁罩7贴合叠加,然后通过固定件8将内壁罩6和外壁罩7固定于底盘2的顶部,随后安装出气管10,转动气阀11将出气管10封堵,开启气泵15,将装置内的气体和微粒杂质吸出,造成装置内的低压环境,随后开启转动电机1使得晶体托架3转动,与此同时,通过输气管12往装置内导入气相物质,并关闭气泵15和通气管14上的气阀11,输气管12导入的气相物质在输气喷头13的作用下散落于晶体托架3上的半导体晶体上,并控制下极片5和上极片9工作,提高镀膜工作效率,同时开启出气管10上的气阀11,通过出气管10对气相物质进行回收再利用。
尽管参照前述实施例对本发明进行了详细的说明,对于本领域的技术人员来说,其依然可以对前述各实施例所记载的技术方案进行修改,或者对其中部分技术特征进行等同替换,凡在本发明的精神和原则之内,所作的任何修改、等同替换、改进等,均应包含在本发明的保护范围之内。

